
- 商品検索:カテゴリ
- 3D白色干渉顕微鏡・変位計 Nexensor

3D白色干渉顕微鏡・変位計(高速・高精度・大面積)
表面粗さ、段差、高さ、深さ、三次元構造、膜厚、膜分離測定
検査装置や生産ラインへの組み込み用
nXI-5シリーズ
高速にサブマイクロスケールの構造を把握
3D白色干渉顕微鏡・変位計

- ・1秒以下の測定時間
- ・1回のスキャンで表面と膜の下の構造を測定
- ・段差、幅、角度、体積、粗さ、平坦度などの測定
- ・顕微鏡タイプ、タレットタイプ
nXI-2シリーズ
高速に大面積の形状測定
大面積・広範囲3D白色干渉変位計

- ・最大視野 33mm×22mm
- ・量産ライン向きの高速測定
- ・μmスケールの構造の観察が可能
- ・ソフトウェア付属
nXV-1シリーズ
正確な変位と厚さの測定
近赤外干渉式厚み・変位センサ

- ・光量調整可能で不透明膜にも対応
- ・オンラインで使える高速リアルタイム計測
- ・二次電池のシリング厚さ、
PCコンフォーマルコーティング厚さなど - ・最大16チャンネル
研究・開発・品質管理に最適なスタンドアローンのシステム
nXI-5SC/nXI-5STシリーズ
研究・開発・品質管理に最適な
スタンドアローンシステム
顕微鏡型
3D白色干渉変位計

- ・1秒以下の測定時間
- ・1回のスキャンで表面と膜の下の構造を測定
- ・段差、幅、角度、体積、粗さ、平坦度などの測定
- ・顕微鏡タイプ、タレットタイプ
nXF-5Dシリーズ
最大310mm角の広い視野の
WarpageとBowをワンショットで測定
3D自由面測定システム
スタンドアローンタイプ

- ・2D,3Dのデータを1度に取得
- ・ウェハ全体をワンショット測定
- ・最大視野 310mm×310mm
- ・反射面の測定
- ・専用ソフトウェア付属
- ・専用測定ケースで毎回同じ環境での計測を実現
nXV-1シリーズ
正確な変位と厚さの測定
光量調整可能で不透明膜にも対応
近赤外干渉式厚み
変位センサ

- ・オンラインで使える高速リアルタイム計測
- ・二次電池のシリング厚さ、
PCコンフォーマルコーティング厚さなど - ・最大16チャンネル
ローラーセルの自動測定によりセル管理と生産性を向上
MLCCローラーセル自動測定装置
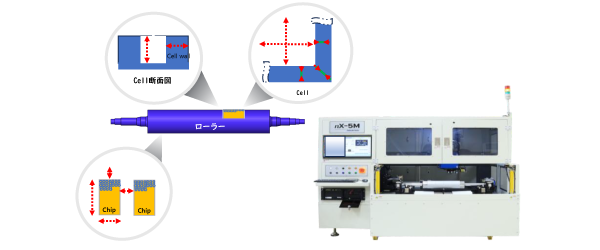
- ・セル幅・高さ・深さ・幅の変化等の自動精密測定
- ・繰り返し精度 0.2μm
- ・ローラーを損耗させない非接触式
- ・摩耗状態を把握しメンテナンスの最適化
- ・自動測定で生産性10倍向上
高い繰返し精度の非接触式自動測定方式により、ローラーを損傷させることなく迅速かつ安定したセルの自動測定を実現。
セル幅、高さ、セル壁幅の変化、深さ、表面粗さを測定することで、ローラーの摩耗具合をモニタリングし、メンテナンスの最適化につながります。手動での検査に比べ圧倒的な速度で検査できます。
12インチ対応自動検査装置・水平or垂直検査に対応
高速高精度 3D白色干渉変位/半導体検査システム
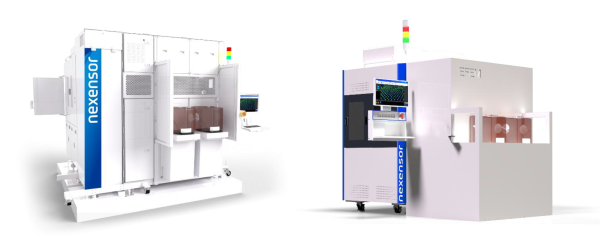
- ・12インチ対応の半導体ウェハ自動検査装置
- ・水平検査、垂直検査に対応
- ・シリコンダイの自動検査
Nexensor社のウェハ自動検査装置は12インチウェハまで対応し、WarpageやBowを高速に検査判定します。
高反射面や透明な面を測定するモデルと反射の少ない状態の測定ができるモデルがあり、検査対象のウェハの状態に合わせた選定が可能です。
独自のコア技術

1.光学技術
・白色干渉法
・分光干渉法
・レーザー干渉法
・モアレ偏光計
・薄膜厚み計測

2.ソフトウェア&アルゴリズム
・光学計測アルゴリズム
・幾何学的解析アルゴリズム
・高速測定アルゴリズム
・測定データ解析機能
・ソフトウェア技術
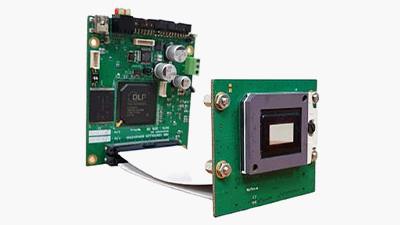
3.回路・工学設計
・光学光回路設計
・光及びレーザー光源制御
・リアルタイム同期処理
・ミラーデバイス制御
・FPGA、DSP、ARM設計技術

3D分析技術
Nexensor社が独自に開発した3D分析ソフトウェア・プログラムnXviewは、素早く測定結果を表示し、測定したデータから様々な分析を行うことが可能です。
ジオメトリー、プロファイル、ピークカウント、ラフネスなど様々な解析機能が提供されています。
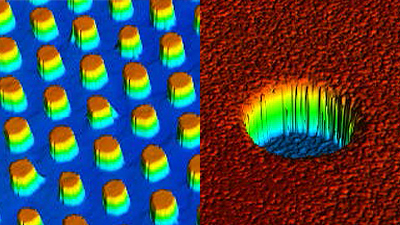
Nexensor社の3D白色干渉変位計・顕微鏡は、次世代半導体ウエハー等の大面積から鏡面又はマットな非光沢測定、コーティングやフィルムなどの薄膜膜厚、実装基板から電子部品、パッケージのμバンプ、マルチレイヤー解析、二次電池のシリングなど多種多様な材料の表面測定、厚み・反り、段差、高さ、深さ、三次元構造、欠陥、膜厚、膜分離測定を高速・高分解能で行え、再現性のある繰り返し精度が高い測定データを提供します。アプリケーションに合わせたセンサー及びシステムを多数ラインアップ。今日の半導体やエレクトロニクス、自動車産業、電子部品・部材工場、研究開発センター、品質管理部門で求められるインラインとオフライン計測に対応した製品を設計・開発し、用途に応じたセンサー又はシステムをご提案しております。

特徴
★ スキャン時間は1秒未満(標準サンプル高さ60μm基準)
★ 大面積から微小部分の計測・解析に対応したモデルラインアップ
★ 数nm以下の粗さ測定が可能、PSIモードでは1~2nm粗さの測定が可能
★ 表面粗さ、厚み・反り、段差、高さ、深さ、3D構造、膜厚など各種測定対応
★ 優れた繰り返し精度
★ 膜分離及び分析機能プログラム搭載(最大3μmの厚さ分離が可能)
★オートフォーカス機能(モデルによるオプション)
干渉法での測定は、基本的に膜の単層を測定します。膜の厚さは比較的薄いことが多く、左上のイメージにあるようなAとBの分離が困難で測定誤差が生じる可能性があります。Nexensorの三次元白色干渉計・顕微鏡では、複数の膜があっても上面と下面を分離して測定できるアルゴリズムが搭載されています。非接触光学ベースの高精度エリア測定方式で、従来の測定速度より5~10倍程度速く、量産ラインにも適応・導入することができます。
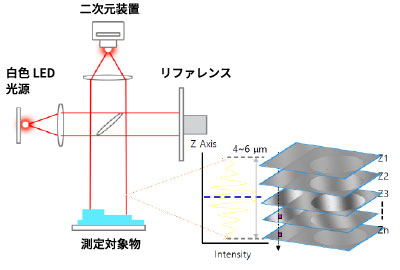
白色干渉測定の原理
白色干渉測定法・WLI(White Light Interferometer)は、光の干渉を利用して測定対象物の表面を測定する技術です。白色光源の光を測定対象物の表面に照射し、反射光と干渉(ビームスプリッターを介したリファレンス光で光路差が生じる)することで光の位相差が生じ、光が再び会ったときに起こる干渉現象を観察することで、測定対象物の表面形状を高い精度で測定することができます。


- 商品検索:カテゴリ
- 3D白色干渉顕微鏡・変位計 Nexensor

